产品
PRODUCT
ALD
原子层沉积(atomic layer deposition,ALD),是一种特殊的化学气相沉积技术,是通过将气相前驱体脉冲 交替通入反应腔室并在沉积基体表面发生化学吸附反应形成薄膜的一种方法具有优异的三维共型性,均匀性 精确的纳米级膜厚控制等特点。
以经典的三甲基铝与水反应生成氧化铝为例:
半反应a:-OH∗ + Al(CH3)3(g ) → - O - Al(CH3)2∗ + CH4(g)
半反应b:- O - Al(CH3)2 + 2H2O(g) → - O - Al(OH)2∗ + 2CH4(g)
总反应:2Al(CH3)3 + 3H2O → Al2O3 + 6CH4
ALD作为一种新型的化学气相包覆手段,能够实现对被包覆材料不规则表面的完全赋型包覆它具有如下特点:
线性可控的包覆层厚度,0.1~0.2nm/cycle;
包覆层均匀且致密;
低温生长,部分薄膜可室温下生长;
可多组分叠层结构生长;
包覆材料选择多样性。
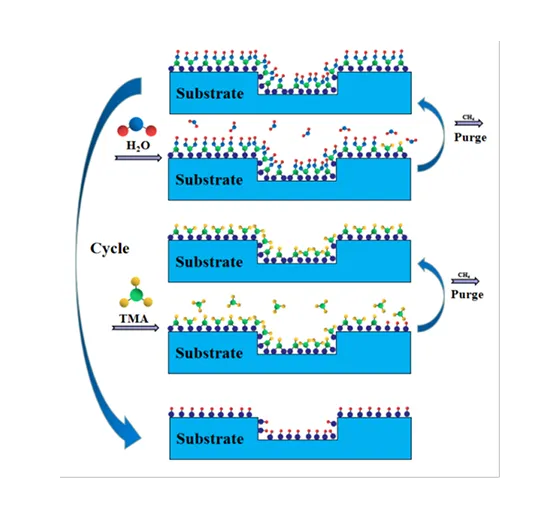
ALD 相关产品
Plasma Batch ALD

PBATCH 批次等离子体ALD
可实现低温高质量的等离子体增强原子层沉积工艺,兼容热式ALD工艺,可在玻璃、有机材料、高分子材料、金属或陶瓷等材质的基底沉积SiO2、Al2O3、TiO2等高质量的薄膜。该设备具有极优的镀膜均匀性、重复性及可靠性,同时兼顾行业领先的产能及良率。

PBATCH-A300 批次等离子体ALD(EFEM可选)
可实现低温高质量PEALD工艺,可在温度敏感的衬底上,沉积SiO2、Al2O3、TiO2等高质量的光学薄膜。亦可在玻璃、硅片、陶瓷、有机材料、高分子材料、金属等材质的基底沉积多种类型的ALD薄膜。可同时兼容热式ALD及等离子体增强ALD工艺。批次性大产能结构设计,大幅提高ALD产能,降低客户使用成本。单位时间内的处理量超越传统PVD镀膜设备。

Multi Pbatch 批次等离子体ALD
Multi Pbatch ALD设备可在极宽的温度窗口(50℃-300℃)内,实现高质量的等离子体增强原子层薄膜沉积工艺,并兼容纯热式原子层薄膜沉积工艺。可在4、6、8、12英寸硅晶圆、化合物晶圆、玻璃晶圆、玻璃镜片、有机高分子镜片、金属或陶瓷等材质的基底沉积SiO2、Al2O3、TiO2、ZrO2、Ta2O5、AlN、TiN等高质量的薄膜。该设备具有极优的镀膜均匀性、重复性及可靠性,同时兼顾优异的产能、良率,及成本控制。
Thermal Batch ALD
